薄膜の実用化のためには界面での密着力を把握することが非常に重要であり、定量的な評価手法の確立が求められてきました。日産アークでは薄膜の密着力を4PB法とDCB法を用いてき裂の開口モードとエネルギー解放率を用いて定量的な評価の受託が可能です。
密着力評価の課題
半導体の性能を向上させるために、構造の微細化や新しい材料の導入が進められています。様々な材料を積層する半導体薄膜には、製造工程や使用環境で生じる熱や力に耐えられる界面の密着力が求められます。この密着力を定量的に評価し、工程にフィードバックすることで、膜の剥離や欠陥を未然に防ぎ、製造工程の信頼性や製品品質の向上につなげることができます。
密着力の定量的評価方法
薄膜試料に基板を貼り付け、曲げ・引張モードで試験を行うことにより、薄膜の界面に剥離を生じさせ、単位面積当たりの界面を剥がすエネルギー量であるエネルギー解放率:Gを測定します。
① 4-point bending法 (4PB法)
多層膜中の最も弱い界面を剥離させた際のエネルギー解放率を測定します。薄膜の密着性評価に有効な手法です。
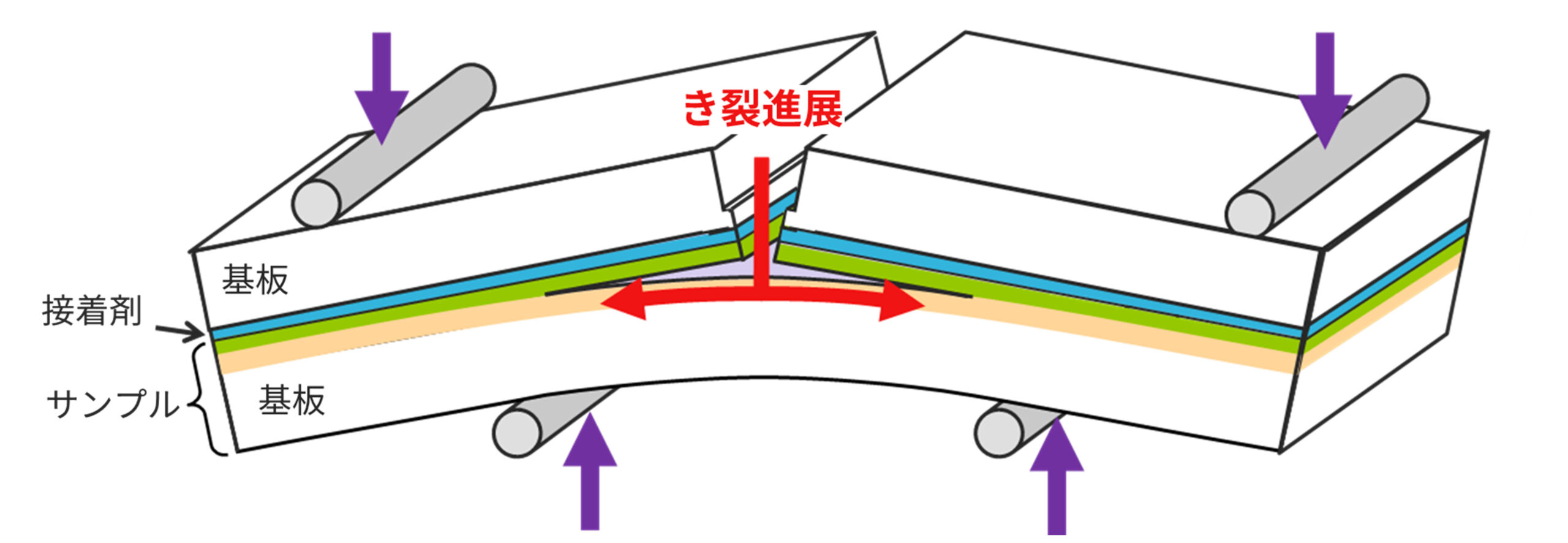
② Double Cantilever beam法 (DCB法)
き裂の進展に伴うエネルギー解放率の変化を計測することができます。面内で密着力に変化がある場合の評価に有効な手法です。
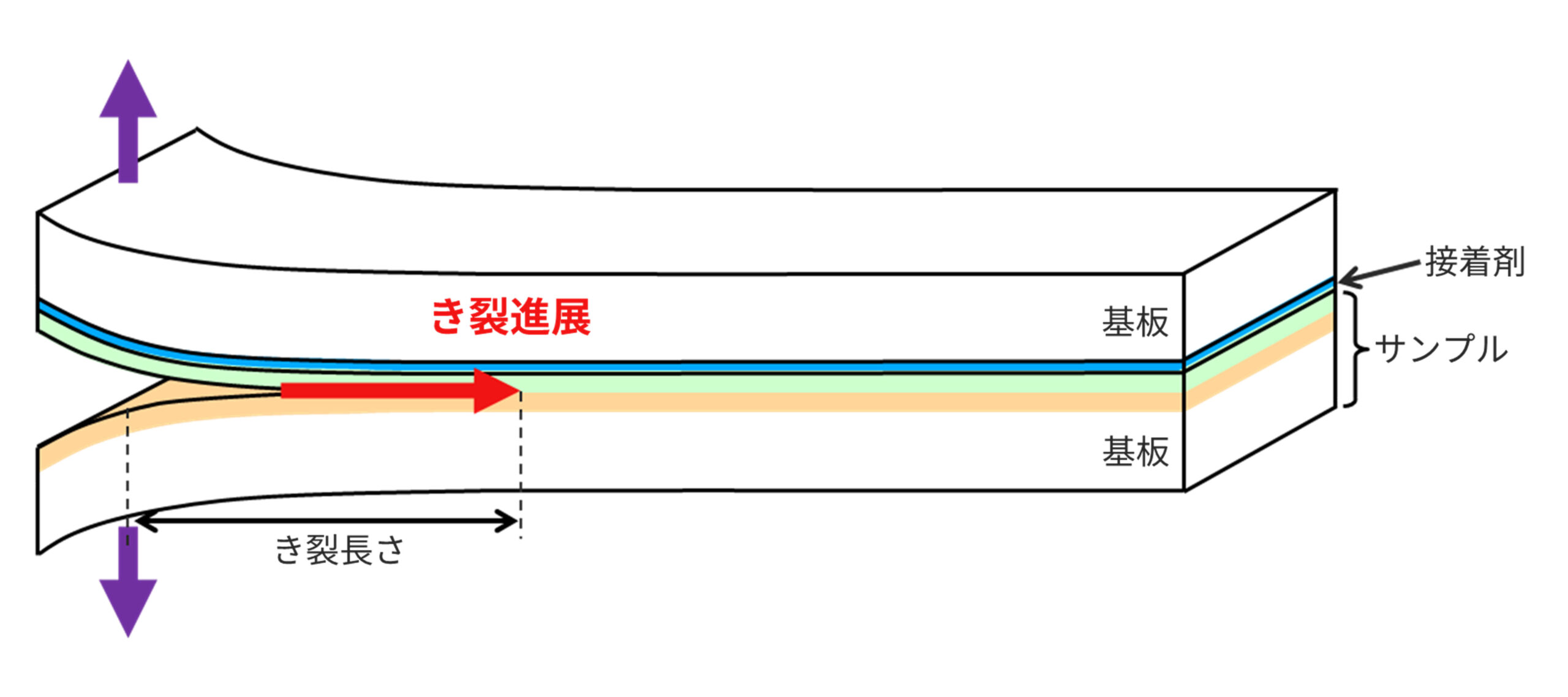
4PB法による評価事例
SiCN/Cu界面のエネルギー解放率を捉えることにより、プラズマ処理の効果を定量的に評価することができます。
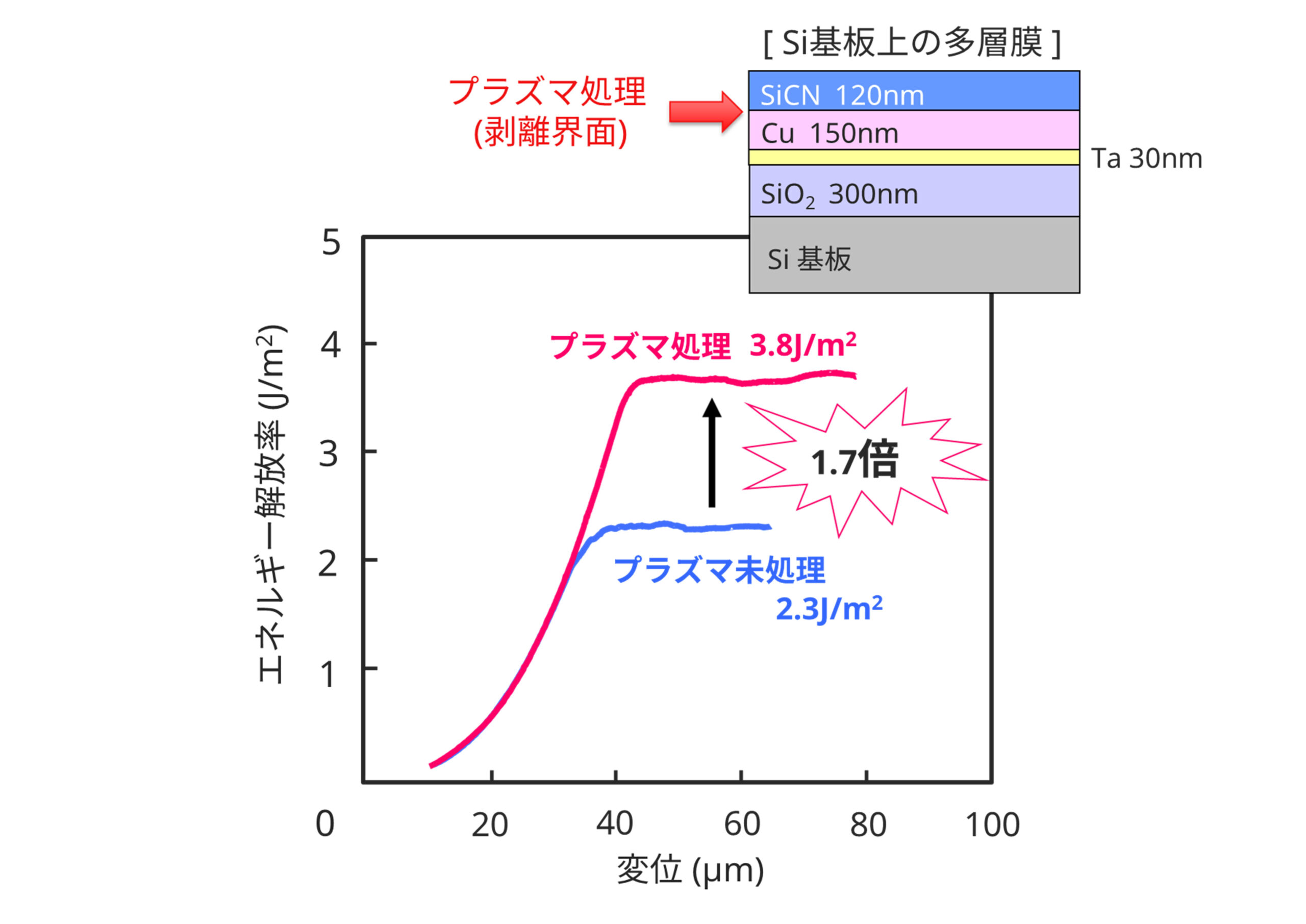
DCB法による評価事例
き裂長さに対するエネルギー解放率の変化と破面のXPS (X線光電子分光法) により、き裂進展経路を推定することができます。
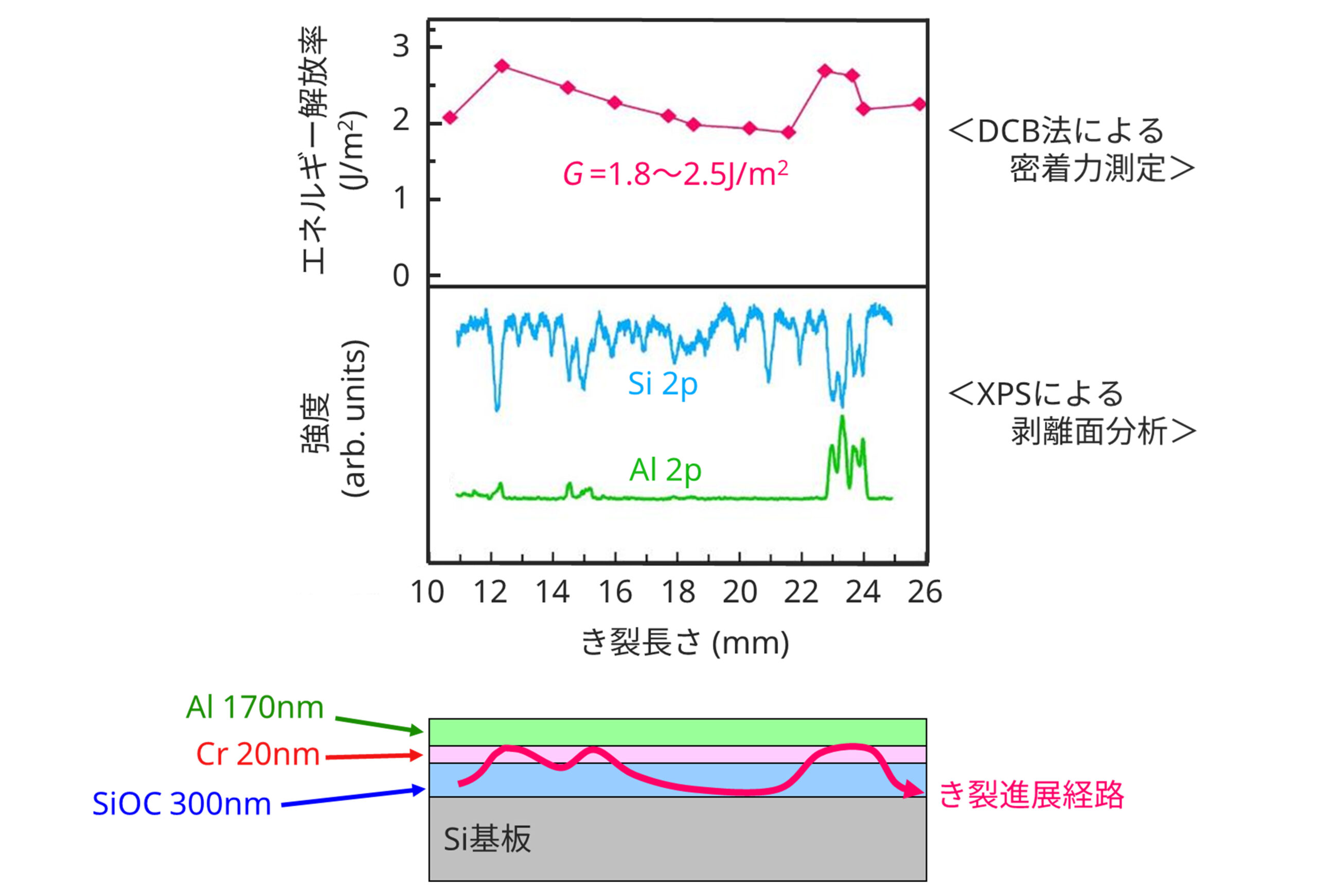
掲載資料をダウンロードできます。
PDF形式
左のアイコンをクリックすると、別ウインドウで開きます。
資料のダウンロードにはお客様情報の入力が必要となります。