Siの化学状態変化を、非破壊・非暴露で分析可能です
軟X線XAFS分析の特徴
低エネルギーのX線を利用した吸収分光法
・軽元素の価数や配位状態の分析ができます。
・表面の構造や電子状態の分析ができます。
・非破壊で深さ方向の化学状態分析ができます。
・大気非暴露で表面分析ができます。
・溶液の測定も可能です。
↓
軟X線XAFS分析は、非破壊・非暴露で
Siの化学状態の深さ方向分析ができます。
■ 測定手法
・部分電子収量法 (~数nm)
・全電子収量法 (~数10nm)
・蛍光収量法 (~数100nm)
■ 利用施設
・立命館大学SRセンター BL10
・あいちシンクロトロン光センター BL6N1

SiO負極の化学状態分析
・充放電に伴う、Siのピークの可逆的なシフトが確認されました。
・充電に伴いSiO2のピークが低エネルギー側にシフトし (シリケート化) 、この変化は不可逆であることが確認されました。
↓
SiO負極の充放電反応において、SiクラスターがLiの脱挿入サイトとして働き、SiO2はシリケート化し不可逆サイトを形成していることが明らかとなりました。
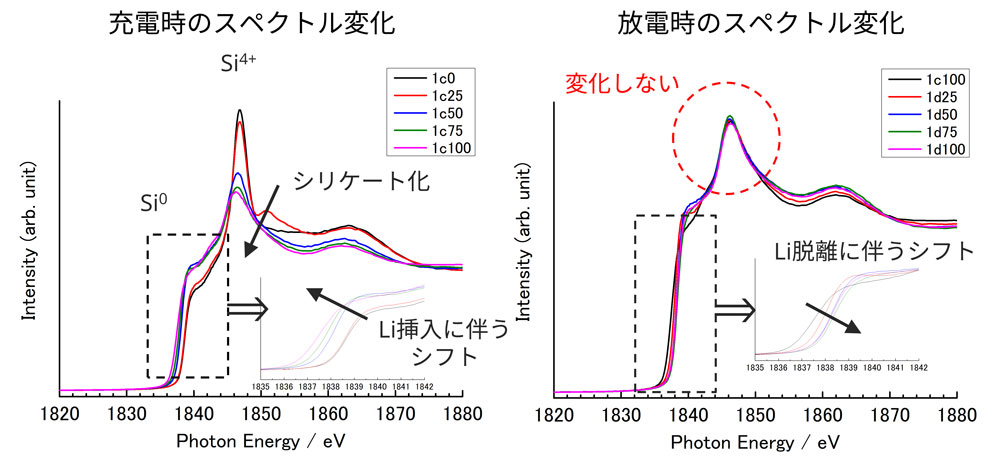
XANESフィッティング、EXAFS解析により詳細な解析も可能です。
※測定は立命館大学SRセンターBL10で行われました。