次世代パワーモジュール (PM) の材料開発を加速させます
次世代PM用材料の耐久性評価サービス
次世代PM用放熱板は高熱伝導かつ低熱膨張、大きな繰り返し温度変化の耐久性が求められ、この要求に応えるためパワー半導体用絶縁基板 (Sub) やベースプレート (BP) の材料開発が行われています。
日産アークでは高信頼Sub/BP構造体開発を支援するため、次世代PM用材料等の耐久性評価サービスをご提供します。
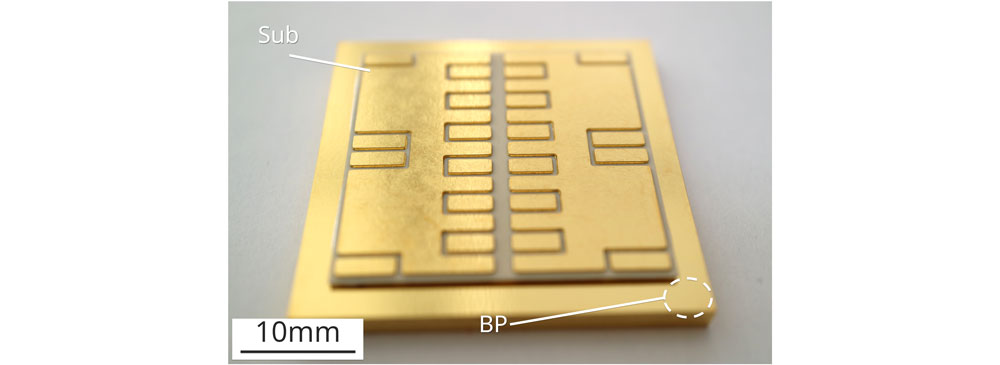
次世代PM用放熱板の解析例
次世代PM用放熱板 (断面構造; Sub/接合材/BP) に対して冷熱サイクル試験を実施し、Sub側上面から超音波顕微鏡で観察しました。Sub/接合材の界面部でSub側コーナー部から中央部の方向へサイクル数増加とともに剥離が進行することが分かりました。
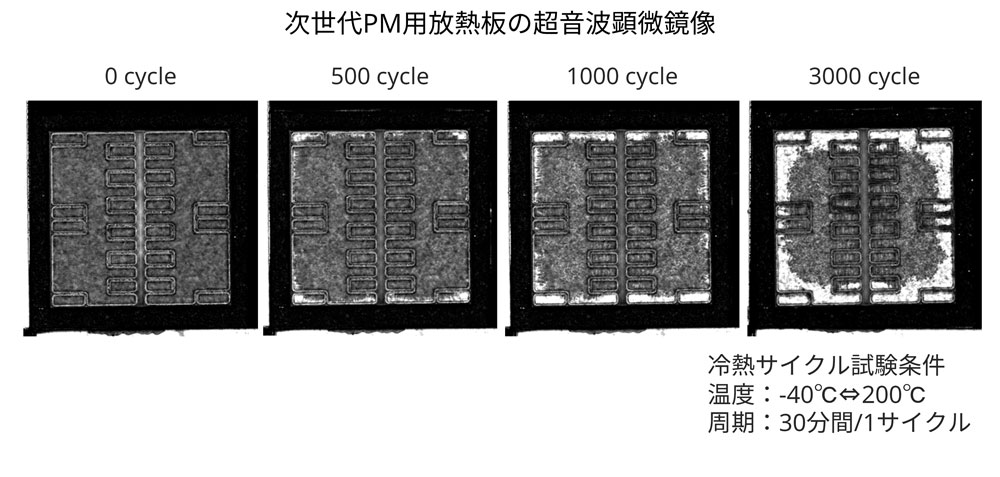
対角方向に断面観察したところ、1000cycle以降のサンプルはSub/接合材界面にて亀裂や剥離が起きていることが分かりました。各部材の平均線膨張係数 (CTE) を考慮すると、冷熱サイクル試験による膨張と収縮の繰り返しで起きる長距離変形がSubの四隅で最大になること、Subと接合材のCTEの差が最も大きいことから、変形に耐えられずコーナのSub/接合材界面から中央部に向かって破壊が進展したと推察されます。