断面TEM-EDX-EELSの駆使がコンタクト解析の近道です
電極剥離問題と解決に向けて
SiCパワーデバイスのn型領域コンタクトにはNi蒸着膜とSiCをアニールして形成するNi2Siコンタクトが多用されています。副産物Cが生成され、コンタクトと接する配線電極や実装電極を剥離させる要因になってます。
問題の認知と対策の確認には断面TEM (透過電子顕微鏡) 及びEDX (エネルギー分散型X線分光) やEELS (電子エネルギー損失分光) が有効です。この問題の解明に携わった日産アークには豊富な経験と知識があります。
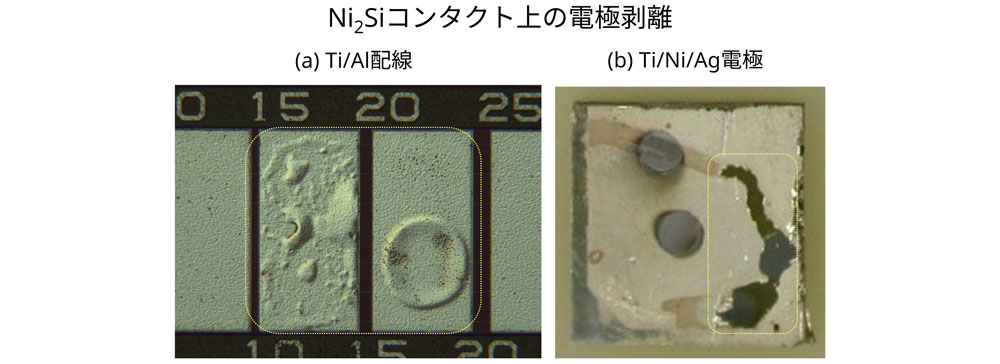
低抵抗Ni2Siコンタクトの精密断面TEM観察
試料は半導体デバイス自体または同じ製造工程を経たTEGでなくてはなりません。右図は10-7 Ωcm2台の低抵抗率を示したNi2Siコンタクトの断面TEM-EDX観察結果です。金属の付着力が乏しく、脆い固体Cがコンタクト表面 (C3) と内部 (C1, C2) にバンド状に析出していることが分かります。電極剥離はC3表面が最も起きやすく、C1, C2が開裂して発生することもあります。下の断面TEM写真はコンタクトアニールの温度とC析出現象の関係を示しています。 C3は比較的低温から現れ、内部バンドC1, C2は <900℃で形成されることが分かります。
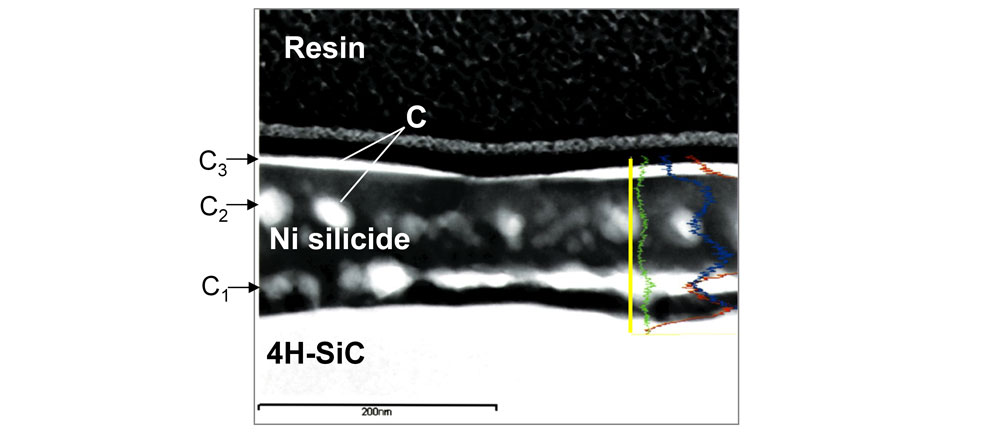
豊富な知見と可能性
電極剥離を防ぐ方向は、 ① C生成量を抑制する、② CをNi2Si 全体に分散させる構造にする、③ 出発材料をシリサイド・カーバイド両方を形成する金属に変更する、④ アニール不要のコンタクトを開発する、に集約されます。これら改良コンタクトを開発する過程 (構造やプロセスの最適化) でも、同様に、断面TEM-EDX-EELSが活躍します。
データご提供:日産自動車株式会社