斜入射X線分析 (Grazing Incidence X-ray Analysis:GIXA) により、薄膜、多層膜やエピタキシャル成長膜などの表面および界面における特性発現メカニズムを原子レベルで把握することが可能です。
物質表面あるいは界面に対して非常に浅い角度でX線を入射すると全反射及び、各界面からの反射による干渉現象が生じます。この現象を用いることにより表面・界面の解析を行うのが斜入射X線分析法 (Grazing Incidence X-ray Analysis:GIXA) です。
従来のX線回折法ではX線の侵入深さが数十μmでしたが、斜入射X線法では数nm~数百nmであることから、薄膜、多層膜やエピタキシャル成長膜などの物質の表面および界面における特性発現のメカニズムを原子レベルで正確に把握することができます。
以下に斜入射X線分析法の特徴について概説します。
反射率測定
標準試料を必要とせず、また大気圧下非破壊で反射率の測定が可能です。界面からの反射X線は入射面に従って干渉し、その結果、生じたフリンジ間の距離や振幅を調べることにより膜厚、密度、および表面、界面の粗さ等が計算できます。
図1にSi3N4 (330nm) / GaAs sub. の反射率測定の結果を示します。全反射臨界角から密度が、全反射臨界角以上にあらわれるフリンジのピッチから膜厚が求められます。さらに反射強度のプロファイルフィットから表面、界面の粗さを求めることができます。反射率測定は、薄膜の膜厚、密度および表面、界面のラフネスの評価に適した手法です。
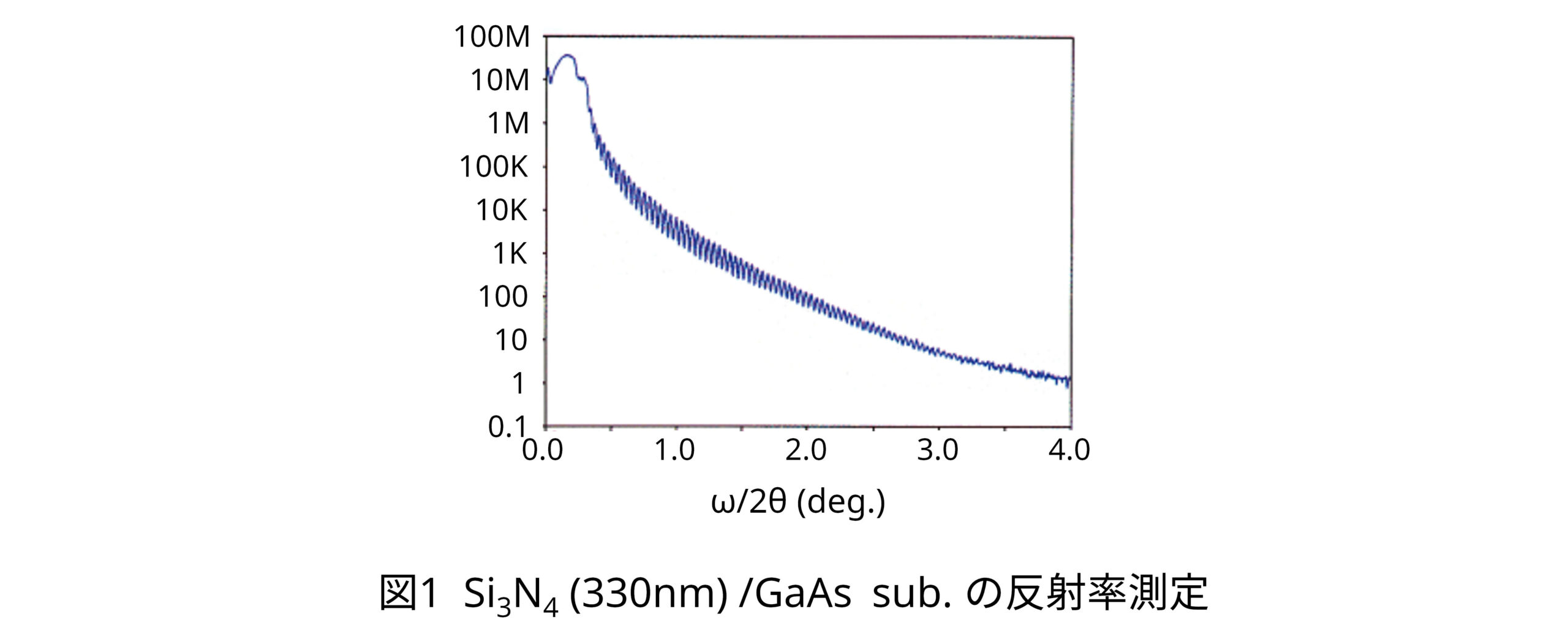
斜入射X線回折
入射X線の侵入深さをコントロールすることにより、数nm~数百nmの表面、個別の多層膜の結晶構造が評価できます。図2は、シリコンウェハーにCu Kα線を入射したときのX線侵入深さの計算例です。全反射が生じるぎりぎりの角度が全反射臨界角です。この付近でのX線侵入深さは100nm未満です。斜入射X線回折により、表面や薄膜の結晶構造を知ることができます。
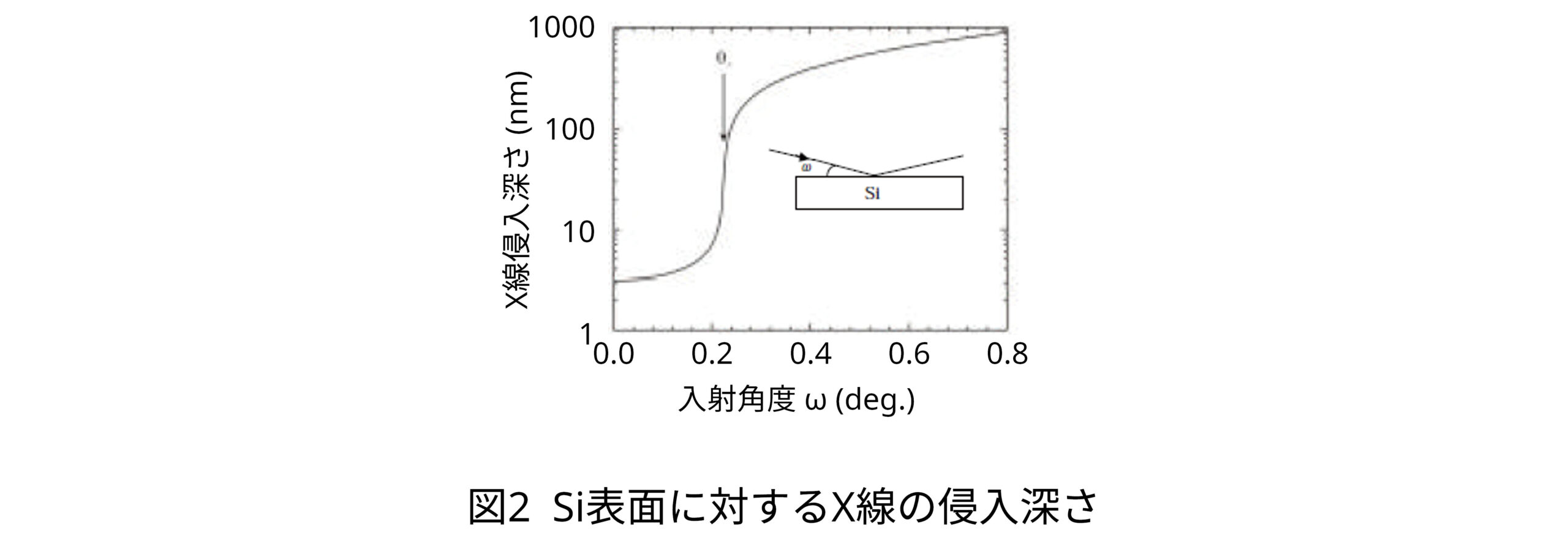
極点図
極点図を用いることで、選択配向性が強い薄膜材料、またはバルク材料の集合組織について、配向方位、配向度が定量的に評価できます。また二軸配向膜と一軸配向膜の区別、極の広がりによる基板面内の回転や双晶の存在についても調べることができます (図3)。
多くの薄膜は配向している場合が多く、それが物性と強く相関していることがあります。極点図は、その評価に最適です。薄膜のほか焼結体などの強配向材料に適用でき、選択配向、集合組織を調べることが可能です。

逆格子マッピング測定
基板と積層膜との格子のミスマッチが大きいと配向性に乱れが生じます。このような場合、基板の測定面と測定結晶面との軸立て、面方位の傾斜方向を慎重に決めなくてはなりません。このような場合に逆格子マッピングは有効です。成膜するときに生じる相やその後の熱処理による複雑な変化を解析できます (図4)。
この図では、横軸のω/2θ方向の強度分布が格子定数の分布をあらわし、縦軸のω方向の分布がモザイシティを表します。
この例ではGa1-xInxAs単結晶薄膜の格子定数の分布は小さく、モザイシティが大きいことがわかります。
逆格子マッピングにより、エピタキシャル成長膜などの単結晶材料の格子定数分布、格子歪み、モザイシティを求めることが可能です。

ロッキングカーブ測定
単結晶薄膜の深さ方向の組成分析および膜厚、超格子の周期を評価できます。エピタキシャル成長膜などの単結晶材料の組成分析、超格子の周期、膜厚を求めることに活用できます。
平行ビーム光学系
平行ビーム光学系を用いることで以下のことが可能です。
・Cu Kα1線のみを用いた高分解能X線回折測定が可能です。この測定により、多結晶材料の定性・定量分析が行えます。この手法は結晶質、非晶質に適用することができます。
・縦横方向のビーム発散を抑えた光学系を用いることで、残留応力測定における試料傾倒によるデフォーカシングを低減し、測定誤差を小さくすることが可能です。結晶質、非晶質からなる多結晶材料の格子定数や残留応力を求めることができます。
・平行ビーム光学では、X線を100μmまで絞ることが可能で微小領域の結晶構造解析ができます。また、サブミリオーダーの空間分解能でマッピング測定も可能です。多結晶材料の微小領域の結晶相同定を行うことができます。
集中ビーム光学系
集中ビーム光学系を用いて、Cu Kα線、Mo Kα線の何れか、または両者を利用したX線回折測定・解析が可能です。これにより多結晶材料の定性・定量分析、結晶子径解析、リートベルト解析などが行えます。この手法は、結晶質、非晶質に適用することができます。
