X線反射率法 (XRR) を用いた薄膜の膜厚と密度の評価原理を解説し、応用事例として三層構造を持つ低誘電率 (Low-k) 膜の測定結果とシミュレーションから求められた積層膜の構造を示します。
X線反射率法 (XRR:X-Ray Reflectivity) とは
X線を非常に浅い角度で試料に入射すると全反射が生じます。この全反射が生じるぎりぎりの角度を全反射臨界角と呼びます。全反射臨界角近傍では、X線の試料への侵入深さは数nm~数100nm程度と非常に小さくなります。この現象を用いる測定方法を斜入射X線分析法 (GIXA) と言います。
一方、全反射臨界角以上では、X線は試料の内部に侵入します。侵入したX線は、図1に示すように薄膜の界面で反射、透過を繰り返し、干渉現象を生じさせます。この現象を捉える測定方法は、X線反射率法 (XRR:X-Ray Reflectivity) と呼ばれ、表面、薄膜の密度、膜厚および界面ラフネス評価に用いられます。

薄膜の密度評価の原理
図2は、Si基板上のCu膜試料について、Cu膜厚を100nm一定とし、Cu膜の密度を変え、X線反射率のシミュレーションを行った結果です。Cu膜のわずかな密度変化で全反射臨界角がシフトすることがわかります。この全反射臨界角の位置から、薄膜または表面の密度を求めることができます。
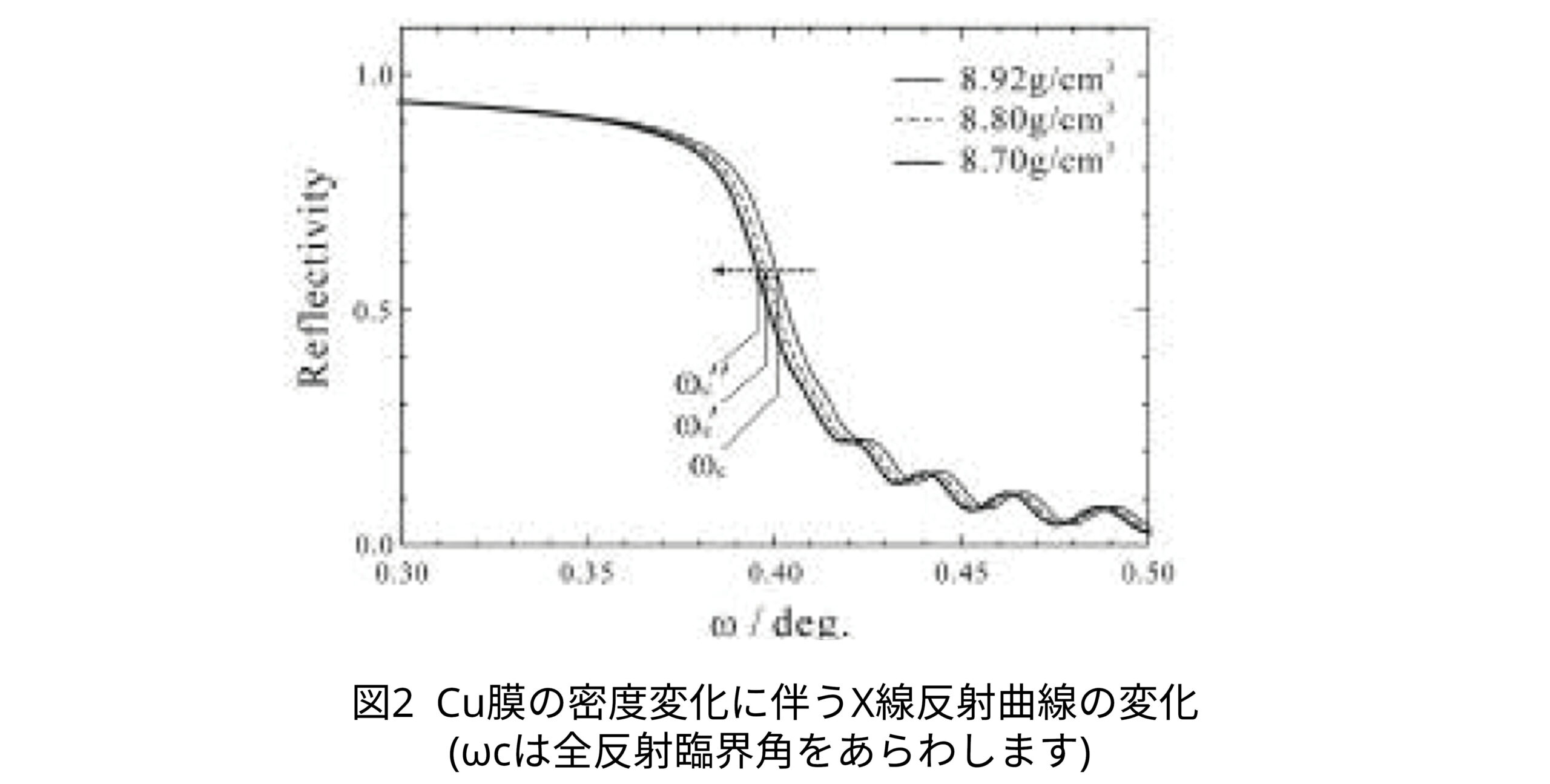
薄膜の膜厚評価の原理
図3は、Si基板上のCu膜試料について、Cu膜の密度を8.92g/cm3に固定し、Cu膜の厚さを変え、X線反射率のシミュレーションを行った結果です。膜厚2nmのケースではほとんどSi基板の全反射臨界角に一致し、Cu膜が厚くなるにつれ、Cu本来の全反射臨界角に近づきます。
また、2nm、5nmのケースでは、次項で述べるX線の干渉によるフリンジの影響も受けるため、本来急峻な反射率変化を示すはずが、ブロードな変化となります。このような場合、全反射臨界角は一概に定義できなくなり、実験曲線に対するシミュレーションを用いた解析が必要となります。

図4は、図3の縦軸をLogスケール表示したものです。薄膜内部でX線は干渉し、その結果、X線反射曲線に振動構造があらわれます。この周期性を解析することで、数nmから数100nmの膜厚を高精度に求めることができます。
また、この振幅は薄膜/基板間の密度差と界面ラフネスに強く依存することから、振幅を解析することで、より詳細な情報を得ることができます。この例で示した単層膜以外にも、複雑な多層膜についても解析することが可能です。


