当社では物質内部の構造や空孔、フィラーなどの分布を三次元画像として観察し、さらにその画像から定量データを得る方法の確立に取り組んでいます。例えばナノ領域を対象とした「透過型電子顕微鏡像の三次元画像化 (3D-TEM) 」やmm~cm領域を対象とした「射出成型品断面の樹脂流れの三次元画像化 (3D/N-ARC法) 」などを開発してまいりました。(図1参照)
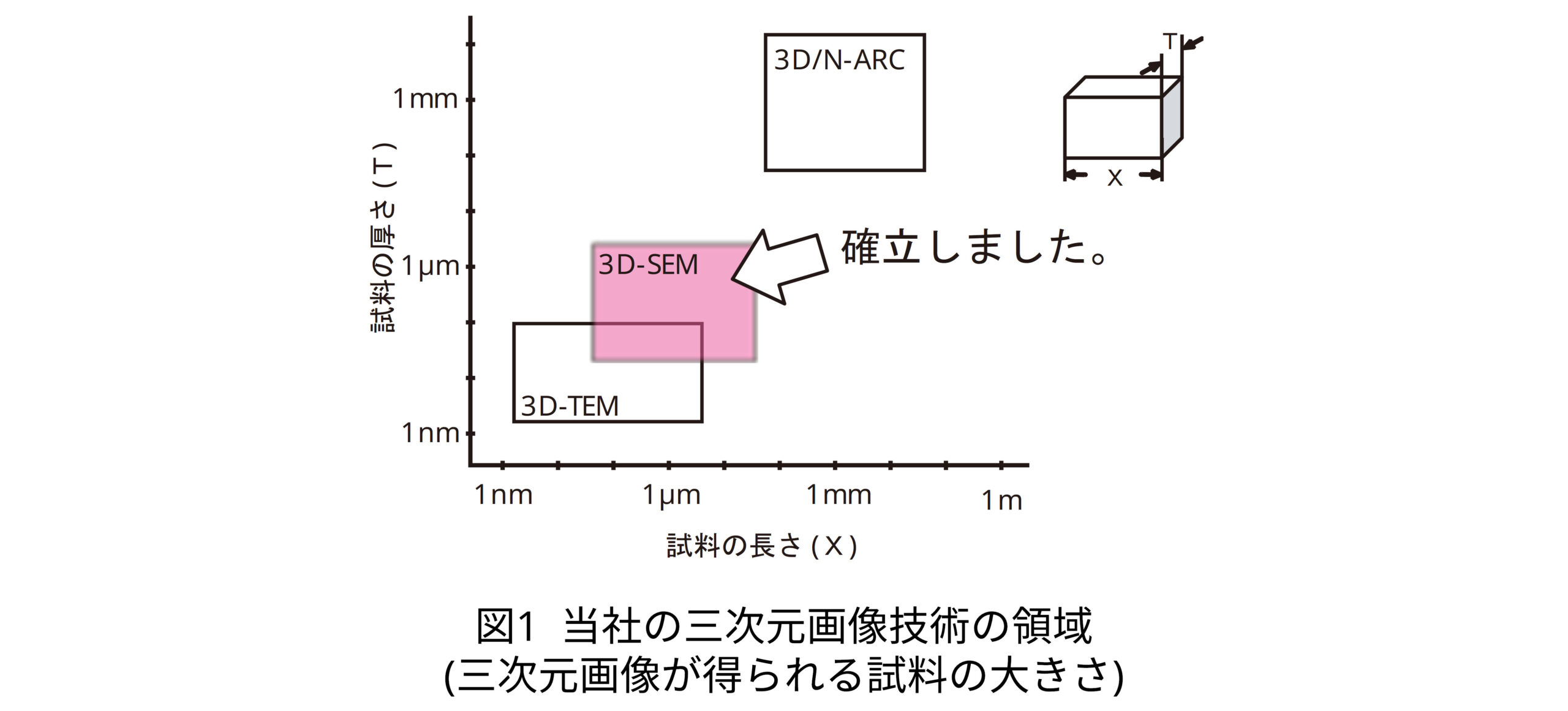
今回はμm領域を対象とした「走査型電子顕微鏡像の三次元画像化(3D-SEM)」についてご紹介します。この画像化は弊社がこれまで培ってきました収束イオンビーム(FIB:Focused Ion Beam)を用いた試料加工技術と三次元画像再構築技術に基づくもので、SEMの新しい応用分野を開拓するものとして注目されています。
観察法
FIBにより特定部位を連続的に加工しながら、順次その断面のSEM像を蓄積します。(当社ではこれを「ぱらぱら像」と呼んでいます)。蓄積されたぱらぱら像から三次元画像を再構築します。再構築された像を画像処理することにより任意の断面で、任意のパラメータ (寸法・体積など) を抽出することが可能です。

