X線回折広域逆格子マッピング法を用いることで残留分極をもつ強誘電体薄膜の不純物相を正しく同定することが可能です。SBT薄膜をサンプルとし、従来のX線回折法による結果と比較することで、その有用性を検証しました。
X線回折広域逆格子マッピング法とは
強誘電体メモリー (FeRAM) では、キャパシター材料にSrBi2Ta2O9 (SBT) やPb(ZrxTi1-x)O3 (PZT) 等の強誘電体薄膜が用いられます。強誘電体の特性である残留分極を支配する諸要因のうち、不純物相の生成はその特性劣化の要因として従来から指摘されています。
劣化の要因となる不純物相の評価には、2θ/θスキャンのX線回折法を用いるのが一般的です。2θ/θスキャンでは散乱ベクトルは図1 (a) に示すように表面垂直方向に固定されます。一方、強誘電体に用いられる薄膜結晶は強い配向を示すことから、結晶相同定に十分な数のX線回折ピークを検出できないことがあります。
この2θ/θスキャン法の弱点を克服したのが、X線回折広域逆格子マッピング法です。図1 (b) に示すように、試料を傾けることにより (ψ方向) 散乱ベクトルを表面垂直方向から傾け、表面から傾いた結晶面からのX線回折を検出することが可能になります。実際には、試料をψ=0° (通常の2θ/θスキャンにおける試料配置) からψ=90°まで、わずかずつ試料を傾けながら2θ/θスキャンを実施します。この測定により、ψ-2θ軸の二次元回折強度マップが得られます。
以下では、X線回折広域逆格子マッピング法を用い、従来の評価法では検出困難な「SBT薄膜中の不純物相」を同定した事例を紹介します。
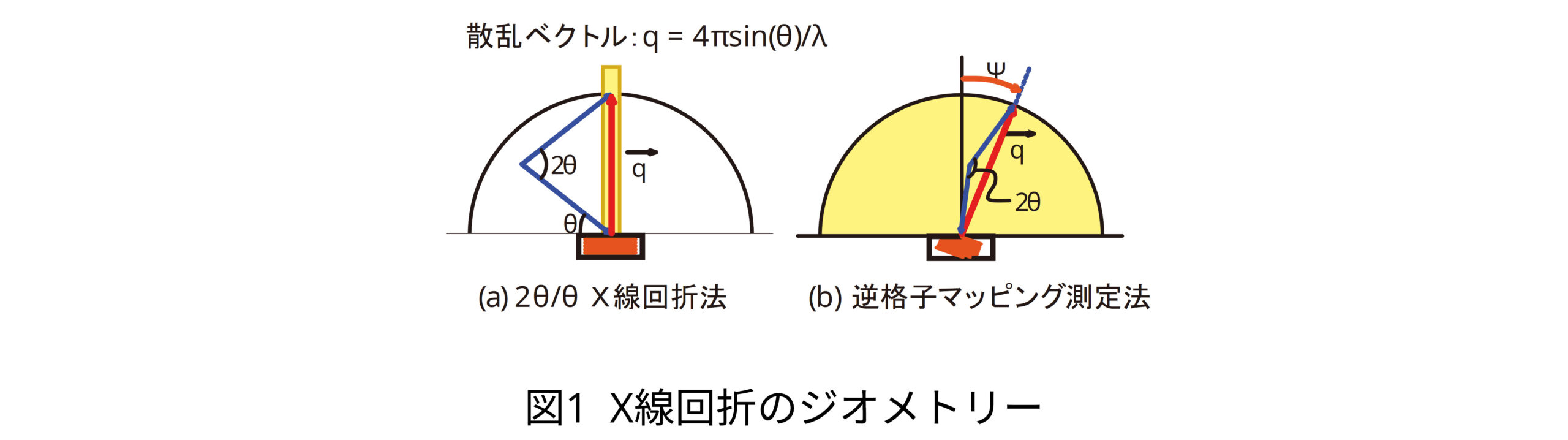
X線回折法による評価の問題点
試料にはSBT/Pt/Si基板を用いました。図2に2θ/θスキャンから得られたX線回折パターンを示します。図中の実線が得られたX線回折パターンで、リファレンスとしてPDFカードによる粉末回折パターンを棒グラフで示しました。29°近傍のピークが顕著で、他のピークはほとんど検出されないことから、(115) 面配向のSBT薄膜と予測することができます。また、いくつかの論文ではPt上に形成されるSBT膜は (115) 面に配向しやすいとの報告もなされています。以上を踏まえれば、従来のX線回折法では、疑念なく、この試料は「不純物のない (115) 面配向のSBT膜」であると断定してしまいます。

X線回折広域逆格子マッピング法による評価
同試料のX線回折広域逆格子マッピング測定結果を図3に示します。左図のψ=0°の結果が、図2のパターンに相当し、また、赤丸でマークした回折スポットが図2で (115) 面と同定したピークに相当します。
右図は、回折スポットをシミュレートした結果です。SBT薄膜は (103)、(013) 面に配向し、僅かに (001) 面配向成分が確認されました。しかし、図2で予測した (115) 面配向の回折スポットは再現されず、図2の結果と矛盾します。残った回折スポットを矢印でマークし、そのスポットについて結晶対称性と2θ位置から解析した結果、図2で (115) と同定したピークは「不純物のフルオライト相」であることが確認できました。
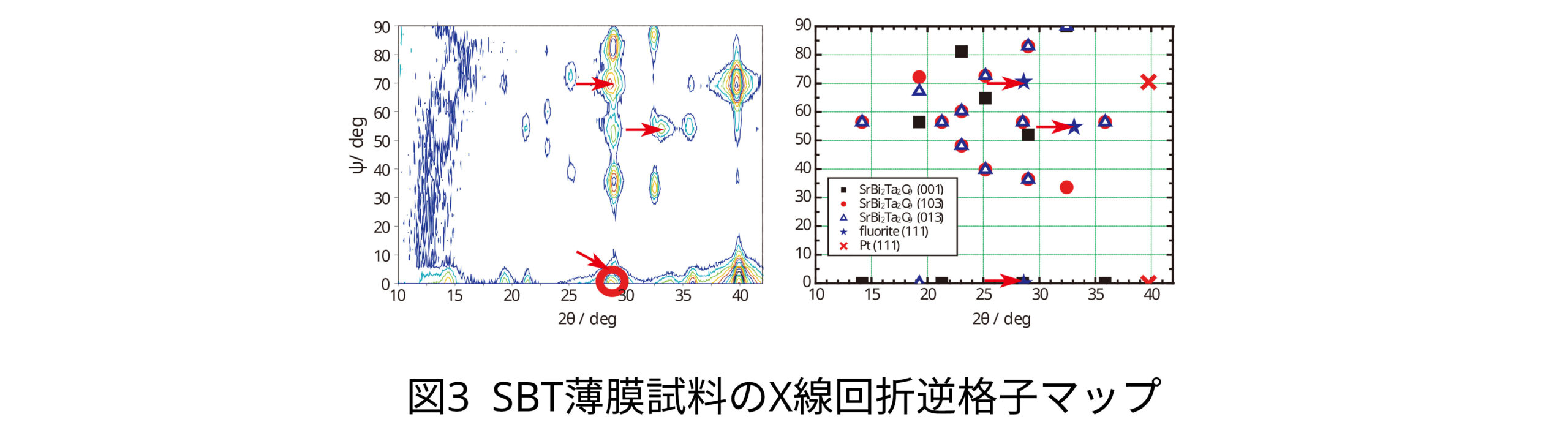
最後に
SBT以外でも多くの薄膜材料は強い配向性を示します。そのような薄膜材料の解析には、X線回折逆格子マッピングを適用することが有効です。是非ご利用ください。
※謝辞 本稿でご紹介したSBT薄膜試料は (株) 日本製鋼所様よりご提供頂きました。ここに厚く御礼申し上げます。
