透過電子顕微鏡 (TEM:Transmission Electron Microscope) は、微細構造の解析には不可欠な分析装置です。最近のナノテクノロジーの研究開発の進展に伴いTEMで観察した部位の元素分析のご要望が多く寄せられています。
しかし、従来のTEMでは点分析しかできませんでした。当社ではこれらのご要望にお応えすべく元素分析機能を充実した新しい概念の電界放射透過型分析電子顕微鏡 (FE-TEM:Field-Emission Transmission Electron Microscopy) を導入しました。このTEMは、従来のTEM機能に加え、高角度散乱暗視野法 (HAADF-STEM:High-Angle Annular Dark Field Scanning)、エネルギー分散型X線分光法 (EDX:Energy Dispersive X-ray Spectroscopy) 、電子エネルギー損失分光法 (EELS:Electron Energy Loss Spectroscopy) 、三次元トモグラフィーなどの魅力的な機能を満載しています。
このTEMの導入により元素分析機能が充実しました。
1) 電子エネルギー損失分光法 (EELS) +エネルギーフィルター (EF) 、エネルギー分散型X線分光法 (EDX) を搭載していますので軽元素から重元素まで分析が可能になりました。
2) 電子線を走査しながら像観察と元素分析が可能な走査透過電子顕微鏡 (STEM:Scanning transmission electron microscope) 機能を有しています。この機能を利用し、極微小部を観察しながらライン分析、元素マッピングが可能です。 (EPMAやSEMと同じような元素分析データが得られるとお考えください)
3) Zコントラストによる簡易組成像が得られます。
このTEMでは高角環状暗視野像 (HAADF-STEM像) を得ることも可能です。HAADF-STEM像は、高角側に散乱された弾性散乱電子を円環状検出器で集めて像信号を得る手法です。この像は回折コントラストの影響をほとんど受けず、またそのコントラストは原子番号(Z)のほぼ2乗に比例するという特徴があります。従って得られた像がそのまま組成情報をもつ二次元マップともなり得ます。
以下では、これらの機能を活用した軽元素の分析事例としてSiデバイスとセラミックス、重元素の分析事例としてDRAMとGaAsのAlAsの量子井戸を紹介します。
軽元素の分析事例
(1) EELSによるSiデバイスの元素マッピング (EF-TEM)
シリコン (Si)、窒素 (N)、酸素 (O) の元素マッピングを図1に示します。この結果から、矢印部の構造が数nmの厚さの酸素-窒素-酸素 (O-N-O) 構造であることが分かります。このようにEF-TEMは高い解像度で元素マッピングが可能です。特に軽元素の微小領域分析に威力を発揮します。
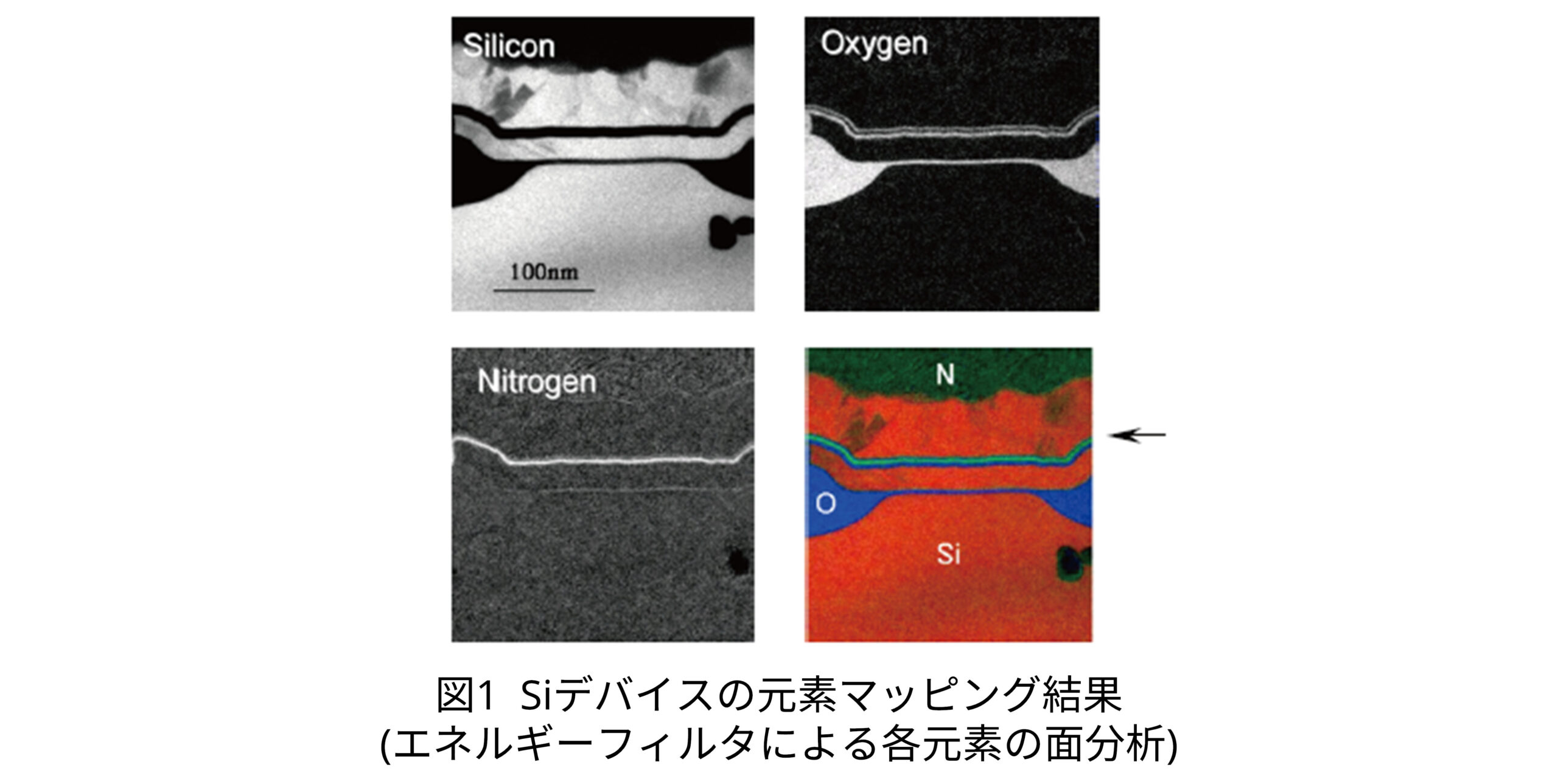
(2) HAADF-STEMとEDXによるセラミックス材の元素マッピング
図2にセラミックスのHAADF-STEM像とEDXによる元素マッピングの結果を示すます。
最上段に示したHAADF-STEM像において粒状物とその粒界相が観察されました。粒界相の方が白いコントラストを示すことから重い元素が含まれていると推測されます。EDXマッピングの結果から、粒界相には主に酸素 (O)、イットリウム (Y) が、粒状物には窒素 (N) が含まれていることがわかります。
また、粒状物の中に炭素 (C) からなる領域がみられました。この領域はOとNを含まないので炭化物の存在が示唆されます。

重元素の分析例
(1) HAADF-STEMとEDXによるDRAMの元素マッピング
図3の左上に示したHAADF像中の赤枠内の元素マッピングをしました。
・シリコン (Si) +タングステン (W) のマッピング結果 (図3の右上) :SiのK線とWのM線の特性X線エネルギー値が同程度ですので、SiとWが存在する領域が白いコントラストで示されています。
・タングステン (W) のマッピング結果 (図3の右下) :WのL線でマッピングしました。Si (+W) のデータと比較することによりSiとWの領域を分けることが可能です。
・酸素 (O) のマッピング結果 (図3の左下) :白いコントラストを示す微細な領域 (十字で示す位置) が見られます。これより幅が数nm程度の薄い酸化層が存在することが分かります。
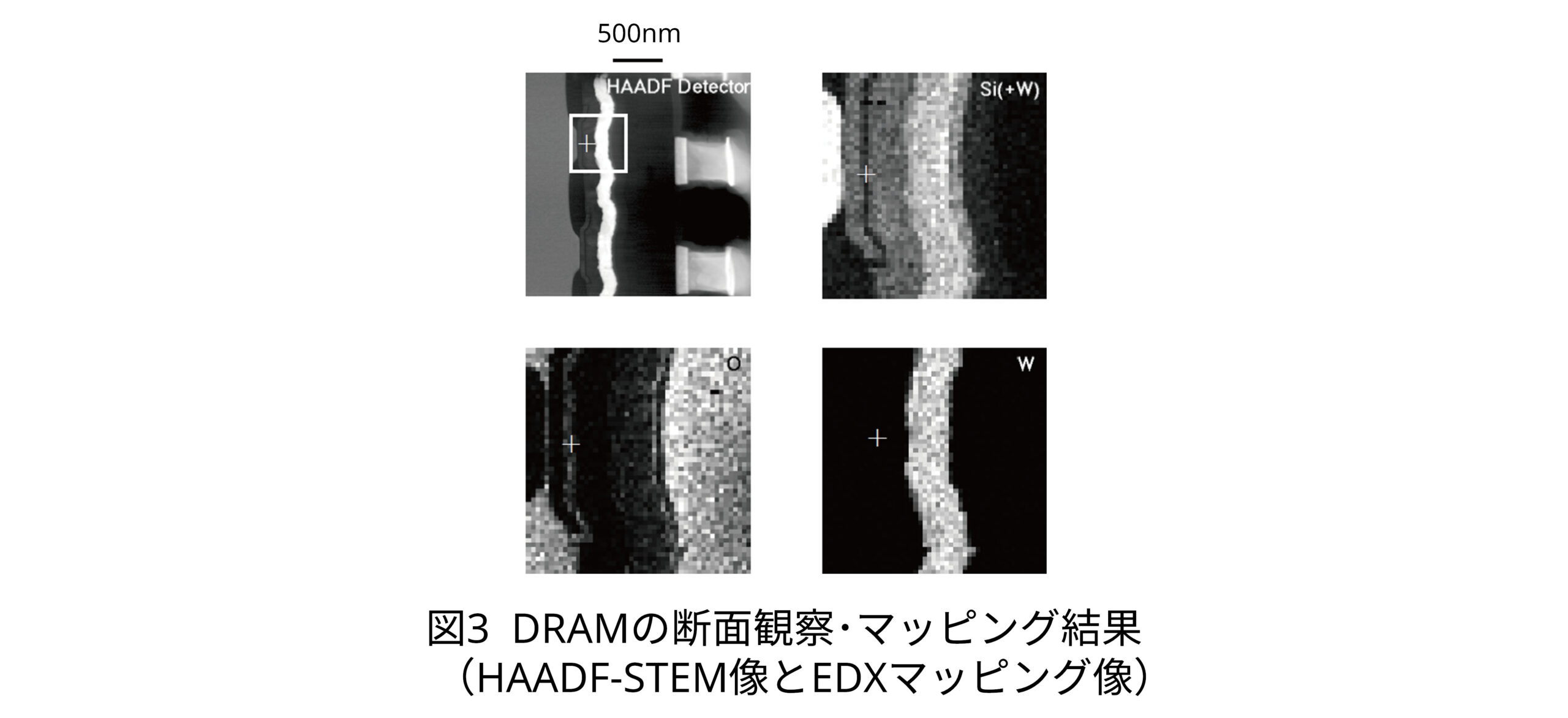
(2) HAADF-STEMとEDXによるGaAsのAlAsの量子井戸のライン分析
HAADF-STEM像の分解能は約0.2nmですので、幅が数nm程度の多層膜界面も明確に観察することができます。
図4に示したライン分析結果から、HAADF-STEMで白いコントラストを示す領域がGaAs層で、黒いコントラストを示す領域がAlAs層であることがわかります。また多層膜の界面で急激にピーク強度が増加および減少していることから、ライン分析の位置分解能が高いこともわかります。
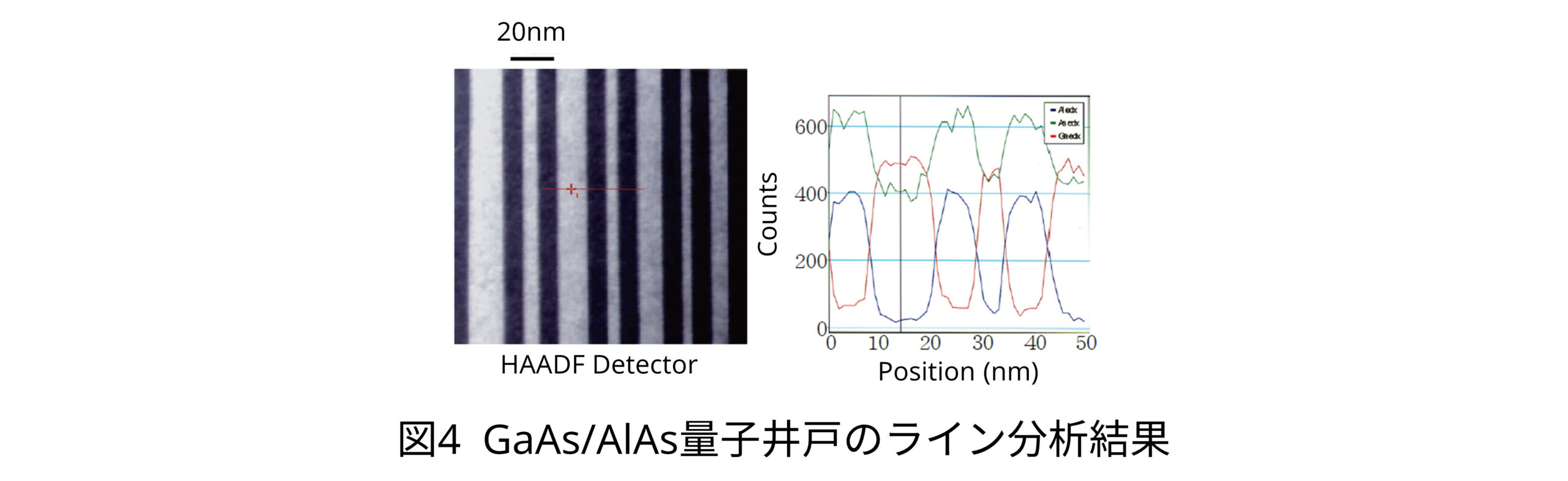
FE-TEM装置概要
●装置名称 FEI社製 Tecnai G2 F20 Super-Twin型
●主な仕様
1) 最高加速電圧:200kV
2) 電子銃:ショットキー電界放射型
3) 対物レンズ形式:Super-Twin (分析形式)
4) 分解能 (FE-TEM) :線分解能 0.24nm点分解能 0.10nm
5) 分解能 (STEM) :0.20nm
6) 分析機能
・エネルギー分散型X線分析装置 (EDX)
・エネルギー損失分光器 (EELS)
・ポストカラム型エネルギーフィルター (EF-TEM)
