生成AIや次世代通信技術の進展により、半導体関連技術の開発は加速しており、材料分析の重要性も増しています。
日産アークは、薄膜・界面を中心とした高度な材料分析に強みを持ち、X線CTによる非破壊3D観察や放射光・TEMを用いた構造解析、薄膜物性評価など多様な技術を提供しています。
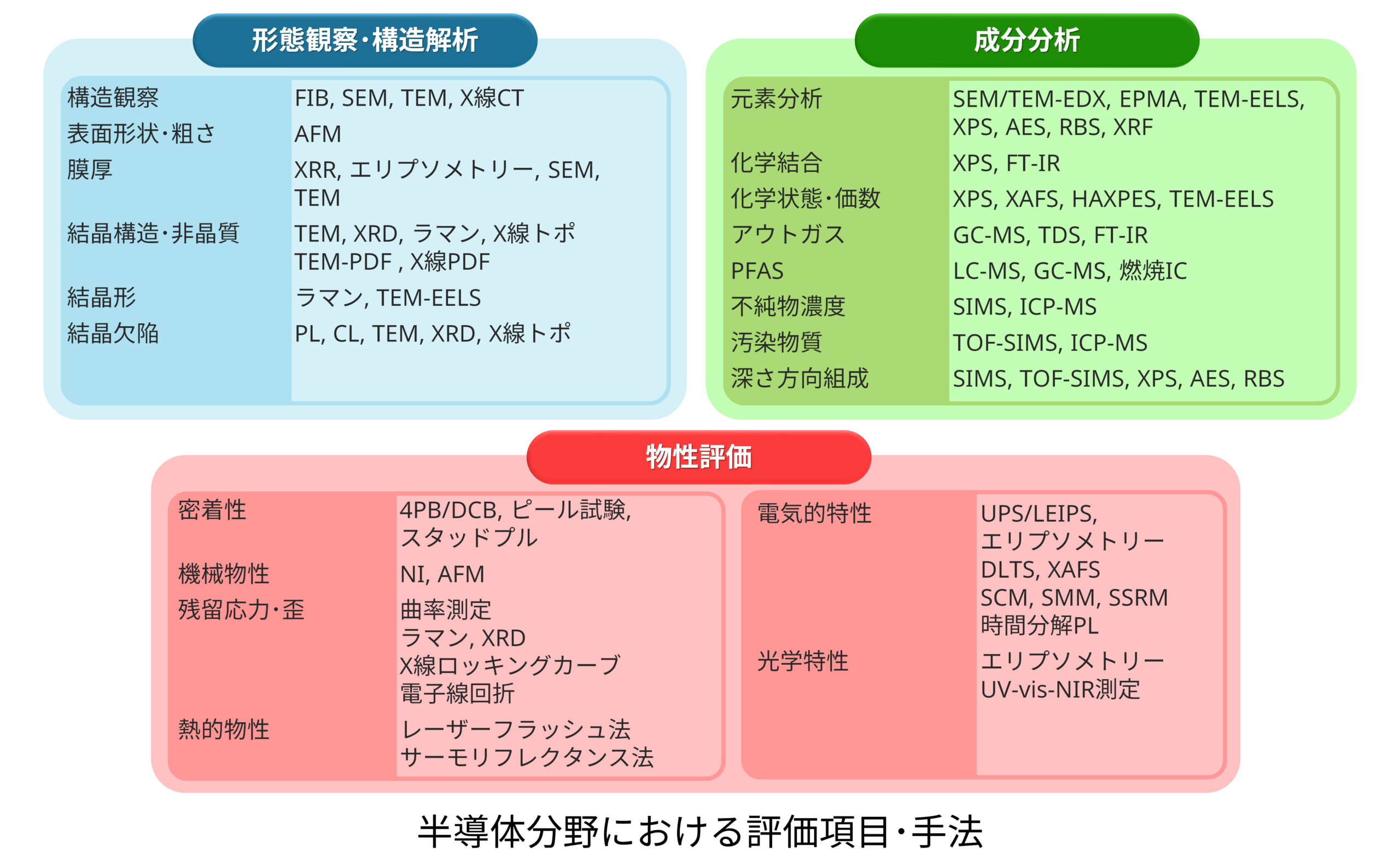 本ページでは、半導体分野で用いられる主要な評価・分析手法のうち、「構造観察」「薄膜の機械物性評価」「表面の電気的特性評価」について紹介します。
本ページでは、半導体分野で用いられる主要な評価・分析手法のうち、「構造観察」「薄膜の機械物性評価」「表面の電気的特性評価」について紹介します。
下線の手法をクリックすると、詳細情報や当社の事例をご覧いただけます。
【目次】(クリックするとその項目へ移動できます)
1.構造観察
・ラボにおける三次元非破壊観察
・電子顕微鏡による観察
・薄膜の非晶質構造解析
・放射光マルチスケールCTによる三次元非破壊観察
2.薄膜の機械物性評価
・密着性評価
・機械物性評価
・内部応力評価
3.表面の電気的特性評価
・電子分光によるバンドエネルギー評価
・SSRMによるナノスケール抵抗分布評価
日産アークは、薄膜・界面を中心とした高度な材料分析に強みを持ち、X線CTによる非破壊3D観察や放射光・TEMを用いた構造解析、薄膜物性評価など多様な技術を提供しています。
下線の手法をクリックすると、詳細情報や当社の事例をご覧いただけます。
【目次】(クリックするとその項目へ移動できます)
1.構造観察
・ラボにおける三次元非破壊観察
・電子顕微鏡による観察
・薄膜の非晶質構造解析
・放射光マルチスケールCTによる三次元非破壊観察
2.薄膜の機械物性評価
・密着性評価
・機械物性評価
・内部応力評価
3.表面の電気的特性評価
・電子分光によるバンドエネルギー評価
・SSRMによるナノスケール抵抗分布評価
1.構造観察
ラボにおける三次元非破壊観察
米Sigray社製ApexXCT-150を国内初導入 (2024.3) し、サービスを開始しました。従来のX線CT装置で用いられている直交型とは異なる斜交型光学系を採用することで、300mmウエハをそのまま非破壊で観察することが可能になるだけでなく、高さ25mmまでのサンプルを最小0.5μmの高分解能で観察することができます。
[分析事例]
・斜交型マイクロX線CT顕微鏡 (XRM) (F809F810)
・斜交型X線CTによるTGVの高分解能非破壊観察 (F199)
電子顕微鏡による観察
当社では、Thermo Fisher Scientific社製 透過電子顕微鏡 Talos F200Z G2 TEMや、クライオプラズマFIB Helios G4 PFIB CXe DualBeamなど、半導体および電子デバイスの分析・解析に活用可能な装置を多数保有しています。Xeプラズマを用いたFIB装置は、従来のGa-FIBで問題となっていたGaによる化合物層の生成がなく、イオン打ち込みによるダメージ層を低減したTEM薄片作製が可能です。また、熱に弱い材料を冷却しながら大面積3D-SEMを取得することもでき、半導体の三次元構造取得などに役立ちます。
[分析事例]
・Xe+ FIB加工を用いたレーザーダイオードのSTEM-EDX分析 (F196)
[関連情報]
・日産アークのWeb立会サービス
・高感度EDX、高傾斜3Dトモグラフィー、クライオホルダ搭載の高感度TEM分析 (F808)
・極低加速電圧走査電子顕微鏡の紹介 (F811)
薄膜の非晶質構造解析
アモルファス薄膜は半導体素子などにも多く用いられており、非晶質構造と薄膜の性能 (光物性や絶縁性など) との関連性について研究が進められています。当社では、nm~サブμmの測定領域を透過電子顕微鏡 (電子線) で測定し、PDF (二体分布関数) 解析を行うことにより、アモルファス薄膜の局所構造の定性分析を行っています。また、μm~mmオーダー領域を放射光施設 (X線) で測定し、PDF解析を行うことで、薄膜の平均的な非晶質構造の定量評価サービスを提供しています。
[分析事例]
・X線PDF (二体分布関数) 解析を用いたアモルファス薄膜の構造解析 (F198)
・TEM-PDF (二体分布関数) による微小領域での非晶質構造解析 (F146)
放射光マルチスケールCTによる三次元非破壊観察
透過能に優れた単色高エネルギー放射光を用いることで、ラボCTに比べて1桁高い分解能の32nm/ピクセルでの三次元観察が可能です。同一の測定装置でマイクロCTとナノCTを相補的に用いることで、サブμm~nmレベルまでのマルチスケール非破壊形態観察が可能です。
本測定は、社外放射光施設を利用することから、申請や実験準備などに時間を要する場合もあります。お早目のご相談をお願いいたします。
[分析事例]
・放射光CTによるリチウムイオン二次電池の高分解能三次元観察 (F516)
(事例は二次電池ですが、半導体や電子デバイスの観察にも活用可能です)
2.薄膜の機械物性評価
半導体のプロセス/デバイスシミュレーションにおいて必要となる薄膜の各種特性や物性について、独自設計の計測手法も加えることで高精度な評価・計測サービスを提供しています。
当社では、半導体基板上に成膜した各種薄膜の密着性について、4PB (4-point bending) 法、DCB (Double cantilever beam) 法という二つの定量的評価手法を提供しています。
試験後の破面をXPS等で分析することで、剥離界面の同定や密着力発現要因を調べることもできます。
[分析事例]
・4PB法による薄膜の密着性評価 (i024)
・Double cantilever beam (DCB) 法による薄膜の密着性評価 (i025)
密着性評価
当社では、半導体基板上に成膜した各種薄膜の密着性について、4PB (4-point bending) 法、DCB (Double cantilever beam) 法という二つの定量的評価手法を提供しています。
試験後の破面をXPS等で分析することで、剥離界面の同定や密着力発現要因を調べることもできます。
[分析事例]
・4PB法による薄膜の密着性評価 (i024)
・Double cantilever beam (DCB) 法による薄膜の密着性評価 (i025)
機械物性評価
下図に示す球形ナノインデンテーション法では、最薄で試料厚さ20nmから弾性率測定が可能です。
この手法では、弾性変形と塑性変形を分離して評価でき、薄膜の降伏接触応力を求めることができます。試料の表面温度は、-150~150℃の範囲で制御することが可能です。
[分析事例]
・球形ナノインデンテーション法の高精度・温度制御測定 (i020)
内部応力評価
平行レーザー群を用いた独自の手法を開発し、サンプルを小型化することで、自重による影響なく、室温から1000℃の範囲で高精度な曲率測定が可能です。
曲率測定結果から、非晶質材料や数nm程度の超薄膜の内部応力、室温から塑性変形開始温度までの内部応力と温度の傾きから薄膜の熱膨張係数を算出することができます。
[分析事例]
・平行レーザー群を用いた薄膜の内部応力測定法 (F158)
3.表面の電気的特性評価
電子分光によるバンドエネルギー評価
半導体デバイス設計において、表面のバンドエネルギーを正確に評価することは重要です。表面や界面でのバンドエネルギーの不整合が、デバイスの劣化や故障の原因となることから、バンドエネルギーを評価することで信頼性の高いデバイス設計が可能になります。当社では、X線光電子分光分析装置 (XPS) として、アルバックファイ社製 多機能電子分光分析装置 VersaProbeⅢを導入し、多彩なオプションを搭載することで、さまざまな電子準位の測定を可能としています。
| 紫外線光電子分光 (UPS) | 仕事関数、イオン化ポテンシャル (価電子帯) 測定 |
| 反射電子エネルギー損失分光 (REELS) | バンドギャップ測定 |
| 低エネルギー逆光電子分光 (LEIPS) | 電子親和力 (伝導帯) ~ LUMO (最低非占有分子軌道) の直接測定 (国内唯一) |
・UPS/LEIPSによるバンドギャップエネルギー解析 (F167)
・UPS/LEIPSによる無機半導体のエネルギーバンド解析 (F200)
SSRMによるナノスケール抵抗分布評価
局所的なキャリア濃度分布やドーピング濃度の空間分布を知ることは、半導体デバイスの性能や信頼性に直結するため非常に重要です。走査型拡がり抵抗顕微鏡(SSRM)は、電気抵抗分布を数十nmの分解能で可視化することができ、シリコンや化合物半導体材料をはじめ、有機半導体や導電性ポリマーなどの様々な導電性材料に適用することができます。当社では、Bruker社製Dimension ICONをベースとした装置を用い、大気非暴露環境での測定にも対応いたします。
[分析事例]
・走査型広がり抵抗顕微鏡法(SSRM)によるナノスケール抵抗分布評価 (F195)